

Microscopia de sondas: uma caixa de ferramentas da nanotecnologia
Fernando Galembeck
Carlos A. R. Costa
Thiago A. L. Burgo
Juliana S. Bernardes
Rubia F. Gouveia
UM BREVE HISTÓRICO Utilizando um microscópio óptico rudimentar, em 1665 Robert Hooke examinou uma fatia de cortiça e verificou que ela era constituída por cavidades poliédricas, às quais ele nominou de células (do latim "cella" – pequena cavidade), descobrindo um mundo até então invisível e insuspeitado. Desde então, os microscópios não pararam de evoluir sendo sempre ferramentas fundamentais para o avanço das fronteiras do conhecimento.
]]> No início dos anos 1980, os microscópios eletrônicos ainda não apresentavam resolução suficiente para visualizar os átomos, embora a teoria atômico-molecular da matéria estivesse bem consolidada, desde o início do século XX. Em 1982, Gerd Binnig e Heinrich Rohrer criaram o microscópio de varredura por tunelamento (STM, Scanning Tunneling Microscope) (1), nos laboratórios de pesquisa da IBM em Rüschlikon, na Suíça. No STM foi possível obter, pela primeira vez, imagens de átomos e essa revolucionária inovação deu a Binnig e Rohrer o Prêmio Nobel de Física, em 1986.Além de produzir imagens em escala atômica, o microscópio de tunelamento permitiu a manipulação de átomos individuais, realizando uma possibilidade que havia sido aventada por Richard Feynman, nos anos 1960, a da construção de estruturas através da movimentação e montagem de átomos, um a um.
O microscópio de tunelamento foi o primeiro membro de uma vasta família que cresceu rapidamente: a dos microscópios de varredura por sonda (SPM, Scanning Probe Microscope). Embora forneça imagens muito impressionantes, seu uso é restrito a superfícies rígidas e eletricamente condutoras, ou semicondutoras. O passo seguinte foi a criação da microscopia de força atômica (AFM, Atomic Force Microscope) (2) por Gerd Binnig, Calvin Quate e Christoph Gerber, em 1986. As primeiras imagens de AFM mostravam a topografia de superfícies sólidas mas agora incluindo materiais eletricamente isolantes, como vidros, cerâmicas, polímeros e materiais de origem biológica, de tal forma que o número de artigos científicos já publicados usando essa microscopia já atinge cerca de 45 mil, enquanto o número de artigos utilizando STM ainda não chegou a 20 mil.
AFM transformou-se, rapidamente em uma vasta plataforma de novas microscopias, que produzem uma grande quantidade de informações sobre as propriedades físicas e físico-químicas de superfícies. Hoje, um microscópio de força atômica complementado com diferentes acessórios permite que se obtenha informações sobre as propriedades elétricas (potencial, carga, condutividade), magnéticas, mecânicas (viscoelasticidade, adesão, dureza, coeficientes de atrito), térmicas (condutividade, transições) e químicas (composição, interações) de superfícies. A Wikipedia lista 28 diferentes tipos de microscopias de sondas e a Tabela 1 enumera alguns exemplos, especialmente das praticadas com diferentes finalidades em plataformas de AFM.
Além de todas essas técnicas, são também realizados experimentos em que se medem vários pares de parâmetros, combinando força vs distância com força vs voltagem, amplitude vs distância, fase vs distância etc.
COMO FUNCIONA Nos microscópios óticos convencionais, o observador utiliza fótons ou elétrons para ver um objeto e as suas possibilidades de observar objetos pequenos ficam limitadas pela difração da radiação, que ocorre sempre que as dimensões do objeto examinado são da mesma ordem de grandeza do comprimento de onda utilizado. Por isso, os microscópios óticos convencionais não permitem a observação de objetos menores que ½ mícron. Além disso, efeitos de aberração comprometem a qualidade das imagens obtidas com grandes aumentos em microscópios eletrônicos, mesmo quando o limite de difração não é atingido.
As técnicas de STM e AFM não dependem da interação da matéria com luz ou elétrons. Nelas, o observador utiliza uma pequena sonda que tem a ponta muito afiada e que percorre a superfície da amostra, muito próximo desta. Em AFM, a sonda pode estar em contato com a amostra, mas, na maioria dos casos, está a uma distância muito pequena, de ordem de poucos nanômetros. Nessas condições, as forças resultantes das interações da sonda com os átomos ou moléculas da superfície, especialmente as interações intermoleculares de Van der Waals, são significativas e podem ser medidas. Em STM, o que se detecta é a corrente de tunelamento entre a sonda e a amostra condutora, que também só é significativa quando a distância entre sonda e amostra é muito pequena(3).
No AFM, a sonda afiada é fixada na parte inferior da extremidade de uma haste montada como uma viga em balanço. As forças que atuam sobre a sonda provocam a deflexão da haste, que é usada para controlar a distância de separação entre a sonda e a amostra durante a varredura da superfície. Para manter a haste sob deflexão constante, portanto a uma distância uniforme da superfície, a amostra (ou a sonda) é levantada ou abaixada pelo movimento de um sólido piezoelétrico ou uma bobina eletromagnética sobre o qual está montada, que, por sua vez, é acionado por uma fonte de tensão controlada pela resposta do detector da deflexão da haste que suporta a sonda. A figura 1 mostra a foto de um microscópio de força atômica com seus principais componentes.
]]>
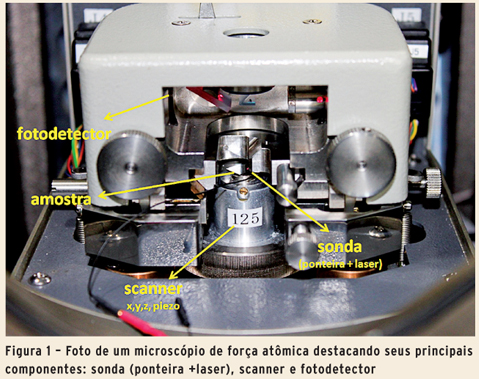
Na primeira técnica de AFM, a sonda permanecia sempre em contato com a superfície, o que pode criar alguns problemas: durante uma varredura, o atrito entre sonda e superfície pode causar riscos e outros danos à superfície da amostra, produzindo também perda da afiação ou a contaminação da sonda.
Para contornar esses problemas, foram criados outros modos de microscopia de força atômica, sem contato entre sonda e amostra ou com contato intermitente. Nestes modos, a haste vibra durante a varredura da superfície e as mudanças na sua frequência de ressonância livre e no amortecimento da vibração da haste, causadas pelas forças entre a sonda e a superfície da amostra, são detectadas e utilizadas para controlar a distância entre as mesmas. O controle da força do contato intermitente entre a sonda e a amostra permite que a sonda varra materiais de todos os tipos, sejam macios ou abrasivos, adesivos, eletricamente isolantes etc.
Na microscopia de varredura por sonda, a sonda interage com os átomos da superfície que estão imediatamente abaixo dela e também com vizinhos um pouco mais distantes. Por essa razão, as imagens topográficas da amostra são geradas pela convolução de muitas contribuições, dos átomos da extremidade da sonda com os da superfície da amostra durante uma varredura. Cada imagem é formada por y linhas com x pontos em cada linha. Cada ponto da imagem é determinado pelas coordenadas x, y e z, onde z é a altura. Portanto, a imagem de força atômica é tridimensional, por definição, diferente de uma micrografia ótica ou eletrônica, que é uma fotografia da projeção bidimensional da amostra.
COMO UMA MICROSCOPIA SE TRANSFORMOU EM UMA PLATAFORMA DE MICROSCOPIAS Como vimos, a microscopia de força atômica se baseia na detecção da deformação de uma haste que suporta uma sonda. Portanto, ela guarda alguma semelhança com instrumentos de medida de rugosidades, chamados de perfilômetros. Pode ainda ser comparada com o uso que um deficiente visual faz de uma bengala: ele percebe as elevações e depressões do terreno, bem como a proximidade de obstáculos, pelas mudanças na altura em que a bengala toca o chão e também pelo som produzido pelo impacto da bengala com o piso. A ponta da bengala é a sonda usada pelo cego, os detectores de alterações no terreno são a sua mão e os ouvidos.
As sondas utilizadas em AFM podem ser usadas de várias maneiras, seja mudando-se as formas de detectar alterações na sua vibração, seja mudando-se a própria sonda de maneira a detectar outras forças, além das de Van der Waals. Por exemplo: uma sonda pode ser recoberta com um fino filme de um sólido magnético. Nesse caso, quando ela se desloca sobre uma superfície magnética, ou que tenha domínios ou regiões magnéticas, a sonda irá responder à componente magnética das interações entre sonda e superfície e a força correspondente será detectada, permitindo que se construa um mapa da distribuição de domínios magnéticos na amostra, com resolução nanométrica, ou seja: uma micrografia magnética.
Esses experimentos podem ser realizados sob diferentes condições ou ambientes (vácuo, temperatura controlada, atmosfera controlada ou ambiente, amostras imersas em líquidos) ou ainda acoplados a técnicas óticas (espectroscopias Raman, de fluorescência, ótica de campo próximo), o que levou a uma quase universalidade das aplicações de microscopias de sonda, em diferentes áreas do conhecimento e de atuação profissional. Ao mesmo tempo, ocorreu uma grande popularização de AFM, viabilizada pela oferta de equipamentos de preço relativamente baixo, no mercado. Hoje, é possível adquirir microscópios de força atômica por preço comparável ao de instrumentos comuns em laboratórios, como espectrofotômetros, analisadores de vários tipos e instrumentos eletrônicos.
Exemplos dos muitos tipos de microscopias de sonda hoje existentes estão na Tabela 1 e alguns casos serão examinados em mais detalhe, a seguir.
ALGUNS CASOS ESPECIAIS
]]> Determinando a topografia da amostraA questão inicial é a escolha da técnica, ou das técnicas combinadas, bem como das sondas apropriadas em função das características da superfície da amostra analisada e do ambiente de varredura: uma amostra hidrofílica exposta às condições ambientes será recoberta por uma camada de contaminação composta principalmente por água, assim como uma amostra hidrofóbica será recoberta por uma camada lipofílica, a não ser que seja obtida e mantida em uma atmosfera extremamente limpa.
STM tem resolução atômica real, porque a interação sonda/amostra ocorre predominantemente com um átomo da extremidade da sonda e o átomo imediato da superfície da amostra. Tem sido utilizada na aquisição de imagens topográficas de alta resolução em ambientes de ultra-alto-vácuo, em sistemas eletroquímicos in situ ou amostras recém-clivadas, como as de grafite pirolítico, cuja superfície está livre de camada de contaminação superficial.
Diversos modos de AFM são utilizados para a obtenção de imagens topográficas e os modos em que não há contato direto entre a sonda e a amostra têm a vantagem de não danificarem a amostra, mas têm menor resolução espacial. Frequentemente, obtém-se imagens topográficas simultaneamente com outros tipos ou modos de imagens, o que contribui, em muito, para a interpretação dos resultados.
Dureza e viscoelasticidade
Em um sistema padrão de aquisição de imagens topográficas por microscopia de força atômica de contato intermitente, a sonda oscila e a sua amplitude é mantida constante mantendo-a a uma distância constante da amostra, por meio de realimentação com um controlador do tipo PID (proporcional, integral e derivativo). Nessas condições, a fase da oscilação da sonda apresenta variações em função das variações topográficas e também da heterogeneidade das propriedades de rigidez, adesão e viscoelasticidade da superfície.
Determinando-se um parâmetro proporcional à defasagem do sinal, este pode ser adquirido e registrado como um mapa de contraste de fase da área correspondente, que informa, por exemplo, sobre a capacidade de dissipação de energia mecânica da região que está sendo varrida pela sonda, pixel a pixel. A inerente sensibilidade do sinal de fase torna esta técnica muito útil na detecção de pequenas variações na superfície da amostra, mas os experimentos devem ser cuidadosamente planejados, adequando a sonda e haste à amostra. O experimentador só consegue explorar bem essa técnica se tiver algum conhecimento de reologia.
Atrito e a Microscopia de Força Lateral (LFM)
Em 1987, Mate et al. (4) determinaram as forças de atrito atuando entre uma ponteira de tungstênio e um único átomo da superfície de uma folha de grafite, detectando a periodicidade dos átomos na superfície do policristal na primeira determinação de forças de atrito em escala atômica. Esse trabalho criou a microscopia de força lateral (Lateral Force Microscopy, LFM) (5), um dos modos de operação mais usados nos instrumentos de AFM.
Enquanto AFM mede a deflexão horizontal da haste da sonda, LFM mede sua torção ou deflexão lateral e a converte em unidades de força. A constante de torção da haste poderia ser calculada conhecendo-se sua geometria e as propriedades mecânicas (módulo de Young, coeficiente de Poisson) do material usado, mas isso é impraticável, pois depende também de um conhecimento detalhado da anisotropia do material (6). Por isso, é necessário calibrar as sondas para medir forças laterais em LFM, executando uma das etapas mais difíceis das microscopias de sondas (6). Pesquisadores importantes propuseram diferentes métodos de calibração e o que obteve maior destaque foi o método da cunha (wedge method). Primeiramente proposto por Ogletree, Carpick e Salmeron (7) e mais tarde revisado por Varenberg, Etsion e Halperin (8), este método é bastante apropriado para ponteiras finas (9) e utiliza uma amostra de calibração que tem uma superfície com ângulos bem definidos, que é varrida sob diferentes valores de forças normais, isto é, da força aplicada à sonda, perpendicular ao plano da amostra. Ao varrer a amostra repetidamente, subindo e descendo planos com inclinações bem definidas e sob diferentes forças normais e medindo a torção da haste, o experimentador adquire todos os dados necessários para calcular o seu módulo de torção. A complexidade do método pode ser avaliada considerando-se que vários outros autores demonstraram outras possibilidades de calibração, mas o método da cunha permanece como o mais aceito. Hoje, LFM é a principal ferramenta na investigação do atrito entre superfícies na escala atômica, tendo revelado que o atrito entre a sonda e uma superfície imersa em um líquido depende muito da carga elétrica dessa superfície (10). Esse é um resultado extremamente importante porque a eletrização de superfícies não tinha sido considerada anteriormente como um fator importante, no atrito.
]]>
MEDINDO POTENCIAIS ELÉTRICOS A distribuição de cargas elétricas ao longo de uma superfície pode ser obtida em escala nanométrica utilizando técnicas derivadas de AFM de não-contato (11; 12). Essas medidas são feitas em dois modos principais, um baseado no método de Kelvin, e o outro na medida direta de forças eletrostáticas. Durante a varredura, uma sonda condutora interage com a superfície da amostra de acordo com as características eletrostáticas da mesma. O potencial resultante em cada ponto é a soma de todos os potenciais elétricos gerados pelas cargas presentes na superfície, como íons e cargas estáticas.
A técnica de microscopia de força Kelvin (KFM) foi desenvolvida em 1991 por Nonnenmacher e colaboradores(13). Ela é análoga ao método de Kelvin, com a diferença de que são medidas forças eletrostáticas atuando sobre o cantilever e não correntes elétricas. A sonda do microscópio atua como um eletrodo de referência, formando um capacitor com a amostra. Ao varrer a superfície em aproximadamente 10 nm de altura, uma corrente AC (alternada) faz a sonda oscilar, enquanto uma corrente DC (direta) é aplicada em cada pixel para zerar a defasagem na frequência AC provocada pelo potencial gerado por cargas fixas na amostra. Esta tensão DC aplicada à sonda iguala o potencial da superfície no ponto adjacente a ela. Assim, a imagem é formada construindo um gráfico de potencial DC aplicado à sonda, pixel por pixel, sendo então convertido em um código de cores predefinido para a construção do mapa de potencial elétrico da amostra, com uma resolução espacial de até 10 nm.
A figura 2 mostra imagens de topografia (esquerda) e de KFM (direita) obtidas simultaneamente de uma mesma região de uma amostra de celulose de eucalipto. A imagem elétrica, apesar de apresentar pequena variação de potencial elétrico (~100 mV), é muito mais rica em detalhes do que a imagem topográfica, revelando uma heterogeneidade elétrica ao longo das fibras de celulose de que não se suspeitava anteriormente.

]]> Medidas de potencial elétrico utilizando microscopia de força elétrica (EFM) seguem uma abordagem diferente da utilizida em KFM. Nesta técnica, as informações de topografia e força elétrica são adquiridas em duas etapas sobre cada ponto da amostra: a 10 nm, onde as forças de Van der Waals são predominantes, são adquiridas as informações topográficas, e a 40 a 60 nm, onde a força eletrostática é predominante, são obtidas as informações elétricas.
Os valores de tensão encontrados nas imagens de KFM correspondem aos valores dos potenciais elétricos na superfície da amostra. No EFM esses valores permitem o cálculo da carga em cada ponto da superfície. O KFM possui uma maior resolução espacial, devido a maior proximidade entre a sonda e a superfície.
UM SUBPRODUTO IMPORTANTE No início dos anos 1980, a medição direta de forças entre superfícies, em função da distância, era feita exclusivamente usando a celebrada "balança de Israelachvili", um instrumento sofisticado e delicado que permitiu ao seu inventor, Jacob Israelachvili, atingir o mais elevado status entre os cientistas dedicados a esse importante tema. O uso dessa balança forneceu resultados memoráveis que nos ensinaram muito sobre os comportamentos muito inesperados da água junto a superfícies sólidas, evidenciando uma estruturação muito intensa, quase que uma cristalização dos filmes de água à temperatura ambiente, causada pela vizinhança de superfícies sólidas. Por outro lado, esse instrumento exigia amostras muito planas, com área macroscópica, o que limitou, em muito, a sua aplicação.
Essa situação mudou radicalmente com o aparecimento de AFM, porque este permitiu a determinação de curvas força vs distância entre praticamente quaisquer superfícies sólidas, separadas por sólido ou líquido. Hoje, é possível medir forças de ordem de alguns piconewtons, com uma resolução de 0,1 nanômetro na distância entre amostra e sonda.
Um exemplo está na figura 3, que mostra a variação da força entre uma sonda de nitreto de silício e uma superfície de politetrafluoroetileno (PTFE, Teflon) eletrizada, durante a aproximação e o afastamento da sonda. Quando a sonda e amostra se aproximam, a sonda é atraída pelo PTFE, até quase tocar a sua superfície quando sofre um puxão adicional, devido às forças de Van der Waals. Forçando-se a amostra para cima, a sonda afunda no PTFE passando a ser repelida, empurrada para cima. Quando a sonda é movimentada para se separar da amostra, a repulsão diminui até tornar-se nula. Continuando a puxar a sonda para separá-la da amostra, observa-se que há uma forte adesão entre ambas, que deforma a haste da sonda até que esta se destaca, quando a força de atração entre sonda e amostra é praticamente nula.

Nesse experimento se aprende muito: observa-se a indução de cargas na sonda e a sua atração pela amostra eletrizada, observa-se e mede-se a contribuição (pequena) das forças de Van der Waals, a resistência do PTFE à penetração da sonda e, portanto, a sua dureza, bem como a adesão entre PTFE e sonda.
]]> Uma modalidade relativamente recente de AFM é a microscopia de força pulsada digital (DPFM). Esta técnica determina automaticamente e sequencialmente três curvas de força em função da distância, pixel a pixel, gerando uma enorme quantidade de dados. Com os dados obtidos em cada ponto, este modo constrói imagens que contêm informações sobre as propriedades mecânicas em escala nanométrica da amostra. As imagens mais comuns que podem ser obtidas simultaneamente são de topografia, rigidez e adesão. Os sinais de rigidez e adesão locais adquiridos na DPFM são representados em tensão elétrica e podem ser convertidos em forças através de uma calibração apropriada.NOVAS POSSIBILIDADES Apesar de todos os desenvolvimentos e sucessos já ocorridos, que incluem um Prêmio Nobel, a criatividade dos cientistas sempre produz surpresas que abrem novas e grandes possibilidades. Um exemplo atual é o da construção de um microscópio infravermelho com resolução nanométrica, que está em curso no Centro Nacional de Pesquisas em Energia e Materiais (CNPEM), em Campinas. O Dr. Christoph Deneke, do Laboratório Nacional de Nanotecnologia e o Dr. Raul Freitas, do Laboratório Nacional de Luz Síncrotron, ambos do CNPEM, estão construindo com suas equipes esse sistema, que deverá estar operando antes do fim de 2013. Esse instrumento deverá produzir imagens microscópicas no infravermelho com resolução nanométrica, isto é, superando uma limitação fundamental de microscópios óticos, que é o limite imposto pela ocorrência de difração.
O QUE SE DESCOBRIU? A importância de novos instrumentos científicos e métodos experimentais é medida, no fim de contas, pelas descobertas que foram feitas e pelo avanço científico que decorreu dos novos métodos.
AFM produziu as primeiras imagens de átomos e tem produzido imagens de moléculas que não são emuladas por outras técnicas. Permite a observação de partículas nanométricas e de micro e nanoestruturas, sendo uma maneira prática e relativamente simples de observar a formação (ou não) de agregados de partículas.
As microscopias elétricas derivadas de AFM revelaram uma insuspeitada complexidade elétrica de materiais isolantes e também de condutores, que está provocando a revisão de muitas ideias sobre fenômenos eletrostáticos. Também está permitindo que fenômenos de atrito sejam compreendidos a partir de interações na escala atômico-molecular, criando uma ponte entre a tribologia macroscópica, clássica, e a teoria atômico-molecular da matéria.
O QUE (AINDA?) NÃO DEU CERTO Apesar dos seus grandes sucessos, algumas das expectativas iniciais sobre as microscopias de sondas não foram cumpridas. No fim dos anos 1980, quando foi adquirido o primeiro microscópio de sondas em uma universidade brasileira, um de seus dirigentes declarou à imprensa que esse instrumento tornava obsoletos todos os demais microscópios. Os fatos posteriores mostram que essa afirmação foi excessivamente entusiástica: entre janeiro e maio de 2013 foram publicados cerca de 4.400 artigos científicos utilizando microscopias eletrônicas, versus cerca de mil artigos utilizando AFM, mostrando o predomínio da microscopia eletrônica. Desde a invenção de AFM, ¾ dos artigos publicados estão nas áreas de "ciências duras" (ciências dos materiais, física, química, engenharias), portanto a sua penetração na área biológica ainda é pequena, bem como nas geociências, arqueologia, ciências forenses e outras que utilizam microscopias.
Também chama a atenção o fato de várias das possibilidades abertas por AFM ainda serem pouco difundidas. O número total de artigos publicados utilizando AFM hoje monta a cerca de 45 mil, mas os números relativos aos seus subprodutos mais especializados são muito menores: MFM, 1161; EFM, KFM, KPFM ou SEPM: 1906; LFM: 288. Portanto, a maior parte da informação que tem sido obtida de AFM é morfológica ou topográfica, apesar das grandes possibilidades de medição de outras propriedades das amostras. A participação brasileira é significativa: grupos do Brasil publicaram 660 artigos sobre AFM, 35 sobre EFM, KFM, KPFM ou SEPM e 108 artigos sobre STM.

]]> Outra perspectiva que não se cumpriu foi a do uso de AFM como ferramenta de nanomanipulação, nanofabricação e nanolitografia. A IBM investiu esforços importantes no projeto Millipede, de uma memória baseada na capacidade de escrita e leitura de uma sonda varrendo um filme de um plástico comum, o acrílico (14). Um protótipo foi apresentado em 2005 e havia a expectativa de comercialização em 2007. Porém, um artigo (com 26 autores) de 2008 relata a situação naquele momento, mostrando que tinha sido conseguida uma densidade de memória de mais de 150 Gb por centímetro quadrado (15), mas que havia ainda vários desafios tecnológicos a superar. Em 2013, essa tecnologia ainda não atingiu o mercado.
Uma possibilidade ainda mais remota, mas que foi muito alardeada no início da década passada, foi a da construção de objetos, átomo a átomo, usando-se nanomanipuladores assemelhados às sondas de AFM. Essa possibilidade só pode ser imaginada ignorando-se a existência do número de Avogadro. Por exemplo: se uma pessoa quiser sintetizar alguma substância química (por exemplo, o metano) montando suas moléculas, átomo a átomo, terá de montar 5 vezes 6.1023 átomos para obter 16 gramas de metano. Caso os nanomanipuladores consigam montar um bilhão de átomos por segundo (o que ainda não foi demonstrado), serão necessários 3.1015 segundos, ou seja, quase um milhão de séculos. Esse é um exemplo de situações que alguns cientistas criam mas que geram descrédito, justamente nas pessoas mais lúcidas.
PERSPECTIVAS A comparação das microscopias de sondas com as microscopias óticas e eletrônicas mostra vantagens e desvantagens de cada tipo. Em consequência, todos os três tipos são amplamente usados e continuam sendo desenvolvidos intensamente. Algumas vantagens encontradas em microscopias de sondas são: os preços dos equipamentos são relativamente reduzidos (15 mil dólares para equipamentos simples, 60 mil para sistemas que já oferecem muitas possibilidades e 250 mil para os mais sofisticados), é possível examinar amostras ao ar e em diferentes ambientes utilizando diversos tipos de sondas reveladoras de diferentes propriedades, muitas amostras podem ser examinadas sem gastar muito tempo no trabalho de preparação e a obtenção de resolução atômica ou molecular é viável – quando necessário. As principais desvantagens são o pequeno tamanho do campo examinado, raramente excedendo uma centena de mícrons, e a relativa lentidão na aquisição das imagens, que pode variar entre dezenas de minutos até algumas horas.
Muitos esforços estão sendo aplicados na ampliação das possibilidades dessas microscopias e há resultados recentes importantes no aumento da resolução e da rapidez na aquisição das imagens. Por exemplo, hoje é possível obter imagens não apenas de átomos mas até mesmo da distribuição de carga elétrica no interior de moléculas, graças à microscopia com sondas Kelvin de alta resolução.
Os progressos dependem muito de aperfeiçoamentos e de novos conceitos na construção das sondas e na eletrônica de acionamento e monitoramento das mesmas. Como sempre acontece em ciência, esses progressos estão sendo realimentados pelo rápido aprendizado sobre as complexas interações entre matéria e energia nas nanoestruturas, isto é, nas escalas atômica e molecular, para os quais essas técnicas estão trazendo uma grande contribuição.
Fernando Galembeck é professor titular do Instituto de Química da Universidade Estadual de Campinas (Unicamp) e diretor do Laboratório Nacional de Nanotecnologia, no Centro Nacional de Pesquisas em Energia e Materiais (CNPEM). Email: fernando.galembeck@lnnano.cnpem.br.
Carlos A. R. Costa é especialista em técnicas e instrumentação em microscopias de sondas do Laboratório Nacional de Nanotecnologia, no CNPEM. Email:calbercosta@gmail.com.
Thiago A. L. Burgo é pós-doutorando do Instituto de Química da Unicamp. Email:tburgo@iqm.unicamp.br.
Juliana S. Bernardes é pesquisadora do Laboratório Nacional de Nanotecnologia, no CNPEM. Email:juliana.bernardes@lnnano.cnpem.br. ]]>
Rubia F. Gouveia é pesquisadora do Laboratório Nacional de Nanotecnologia, no CNPEM. Email: rubia.gouveia@lnnano.cnpem.br.
REFERÊNCIAS BIBLIOGRÁFICAS
1. Binnig, G.; Rohrer, H. "Scanning tunneling microscopy". Helvetica Physica Acta, vol.55, nº 726. 1982.
2. Binnig, G.; Quate, C. F.; Gerber, C. "Atomic force microscope" Physical Review Letters, vol.56, nº 930. 1986.
3. Bray, M. T.; Cohen, S. H.; Lightbody, M. L. Atomic Force Microscopy/Scanning Tunneling Microscopy. New York; London: Plenum. 1994.
4. Mate, C. M.; MacClelland, G. M.; Erlandsson, R.; Chiang S. "Atomic-scale friction of a tungsten tip on a graphite surface". Phys. Rev. Lett., vol.59, nº 1942. 1987.
5. Munz, M. J. "Force calibration in lateral force microscopy: a review of the experimental methods". Journal of Physics D: Appl. Phys., vol.43, nº 6. 2010.
6. Asay, D. B.; Kim, S. H. "Direct force balance method for atomic force microscopy lateral force calibration". Rev. Sci. Instrum., vol.77, 043903. 2006.
7. Ogletree, D. F.; Carpick, R. W.; Salmeron, M. "Calibration of frictional forces in atomic force microscopy". Rev. Sci. Instrum., vol.67, nº 3298. 1996.
8. Varenberg, M.; Etsion, I.; Halperin, G. "An improved wedge calibration method for lateral force in atomic force microscopy". Rev. Sci. Instrum., vol.74, nº 3362. 2003.
9. Tocha, E.; Schönherr, H.; Vancso, G. J. "Quantitative nanotribology by AFM: a novel universal calibration platform". Langmuir, vol.22, nº 2340. 2006.
10. Akbulut, M.; Godfrey Alig A. R.; Israelachvili, J. N. "Triboelectrification between smooth metal surfaces coated with self-assembled monolayers (SAMs)". J. Phys. Chem. B, vol.110, nº 22271. 2006.
11. Galembeck, F.; Costa, C. A. R. "Electric scanning probe techniques: Kelvin force microscopy and electric force microscopy". Encyclopedia of Surface and Colloid Science. New York: Dekker Encyclopedias. 2006.
12. Rezende, C. A.; Gouveia, R. F.; da Silva, M. A.; Galembeck, F. "Detection of charge distributions in insulator surfaces". Journal of Physics: Condensed Matter, vol. 21, 263002. 2009.
13. Nonnenmacher, M.; O' Boyle, M. P.; Wickramasinghe, H. K. "Kelvin probe force microscopy". Applied Physics Letter, vol.58, 2921. 1991.
14. Vettiger, P. et al. "The 'millipede' – Nanotechnology entering data storage". IEEE Trans. Nanotechnol., vol.1, 39. 2002.
15. Pantazi A. et al. "Probe-based ultrahigh-density storage technology". IBM J. Res. & Dev., vol.52, 493. 2008.
]]>